반도체 제조용 웨이퍼 본딩 및 리소그래피 장비 분야 기업인 EV그룹(이하 EVG)이 이종집적화 역량 센터(Heterogeneous Integration Competence Center, HICC)를 설립했다. HICC는 EVG의 공정 솔루션을 활용하여 새로운 애플리케이션을 개발하고자 하는 고객들을 지원하기 위해 설계됐다.
HICC가 지원하는 솔루션과 애플리케이션에는 고성능(HP) 컴퓨팅 및 데이터센터, 사물인터넷(IoT), 자율주행차, 의료 및 웨어러블 기기, 광자 및 첨단 센서 등이 포함된다.

HICC는 EVG의 세계적인 웨이퍼 본딩, 얇은 웨이퍼 처리, 리소그래피의 제품 및 전문성뿐 아니라 EVG 세계 공정기술팀의 지원을 받는 오스트리아 본사 소재 최첨단 클린룸 시설의 파일럿 라인 생산 시설과 서비스 지원까지 제공한다.
HICC를 활용하여 EVG는 고객이 이종집적화 및 첨단 패키징 기술로 신기술 개발을 앞당기고 위험을 최소화하며 차별화된 기술과 제품을 개발할 수 있게 할 것으로 기대하고 있다.
EV 그룹의 마커스 윔플링어(Markus Wimplinger) 기술 개발 및 IP 담당 디렉터는 “이종집적화는 패키징 아키텍처의 혁신을 자극하고 시스템과 설계의 유연성을 높이고 성능을 향상시킨다”고 설명했다.
그는 이어 “EVG의 새로운 HICC는 마이크로일렉트로닉스 공급망 전반에 걸쳐 고객과 파트너가 서로 협업할 수 있는 개방형 혁신 인큐베이터를 제공할 뿐 아니라, 솔루션과 공정기술 자원들을 한 곳에 구비해 둠으로써 이종집적화를 통해 구현할 수 있는 혁신적인 제품 및 애플리케이션의 개발주기와 시장 출시 시간을 줄여준다"고 말했다.
EVG는 이종집적화에 대한 폭 넓은 배경 지식을 보유하고 있으며, 이 핵심 기술 동향을 위한 솔루션을 20년 넘게 제공해 왔다.
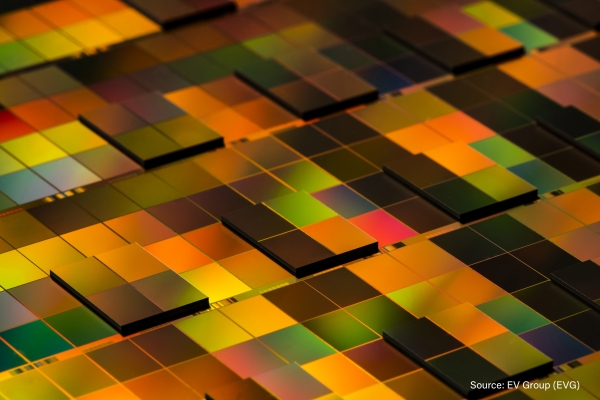
이러한 솔루션에는 ▶3D 패키징과 메탈 본딩을 위한 다이렉트 퓨전 및 하이브리드 본딩을 포함한 영구 웨이퍼 본딩, ▶III-V 화합물 반도체와 실리콘 및 고밀도 3D 패키징의 통합을 위해 집합 캐리어를 사용하거나 사용하지 않는 다이-투-웨이퍼 본딩, ▶기계적, 슬라이드-오프/리프트-오프, UV 레이저를 이용한 임시 본딩 및 디본딩, ▶얇은 웨이퍼 처리, ▶마스크 얼라이너, 코터 및 디벨로퍼, 마스크리스 노광/디지털 리소그래피를 포함한 혁신적인 리소그래피 기술 등이 있다.
패키징 분야에서의 EVG 주요 이력
영구 본딩 분야에서, EVG는 20년 전에 특허를 획득한 SmartView 웨이퍼-투-웨이퍼 정렬 시스템으로 시장을 개척했으며, 이후 수년에 걸쳐 기술을 더욱 개선하여 후면 조사형 CMOS 이미지 센서 (BSI-CIS)와 최근에는 하이브리드 본딩을 위한 100nm 이하 웨이퍼-투-웨이퍼 정렬 오버레이를 시연하는 등, 3D BSI-CIS와 메모리-온-로직 적층 같은 디바이스를 구현할 수 있는 혁신적인 기술들을 선보여 왔다.
리소그래피 기술 분야에서, EVG는 10년 전에 웨이퍼 레벨 옵틱의 대량생산을 위한 최초의 UV 몰딩 솔루션을 제공함으로써 업계 선도적 기술 기업으로서의 입지를 확고히 했으며, 이후 나노 임프린트 리소그래피(NIL) 기술을 대량 생산(HVM) 분야로 확산하는 데 있어 선구자 역할을 했다.


